制程工艺不断提升的同时,整个半导体行业还在持续研究各种先进封装技术,二者结合打造越来越庞大、强大的芯片。
Intel在先进封装技术方面尤其有着悠久的历史和丰富的成果,早在20世纪90年代就引领从陶瓷封装向有机封装过渡,率先实现无卤素、无铅封装,EMIB、Foveros、Co-EMIB如今都已经投入实用,Foveros Direct、Foveros Omni也已经做好了准备。
现在,Intel宣布率先推出面向下一代先进封装技术的玻璃基板,计划在未来几年内推出相关产品,可在单个封装内大大增加晶体管数量、提高互连密度,使得合作伙伴与代工客户在未来数十年内受益。

玻璃基板组装芯片的一侧

玻璃基板测试芯片
目前普遍采用的有机基板封装预计会在2020年代末期达到晶体管缩微能力的极限,因为有机材料耗电量比较大,存在缩微、翘曲的限制。
相比之下,玻璃具有独特的性能,比如超低平面度(也就是极为平整)、更好的热稳定性和机械稳定性。
使用玻璃材料制成的基板,具有卓越的机械、物理、光学特性,可以在单个封装中连接更多晶体管,提供更高质量的微缩,并支持打造更大规模的芯片,也就是系统级封装。

玻璃基板测试单元

Intel CEO基辛格展示玻璃基板测试晶圆
Intel表示,玻璃基板更高的温度耐受可使变形减少50%,便于更灵活地设置供电和信号传输规则,比如无缝嵌入光互连、电容、电感等器件。
同时,玻璃基板极低的平面度可改善光刻的聚焦深度,整体互连密度有望提升多达10倍,还能实现非常高的大型芯片封装良率。
Intel的目标是到2030年实现单个封装内集成1万亿个晶体管,玻璃基板将是推动这一目标落地的强有力支持。
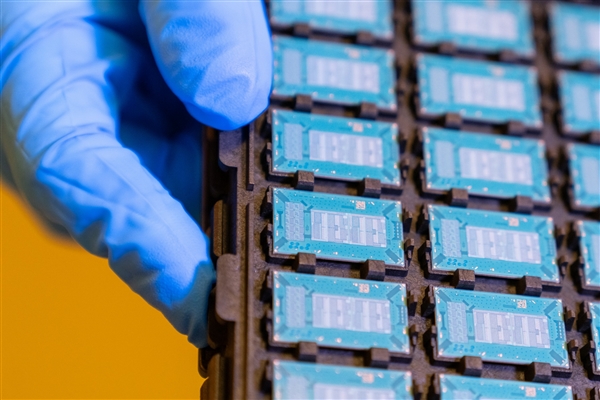
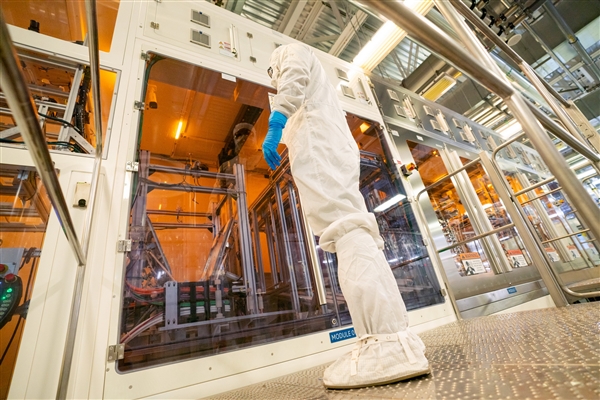
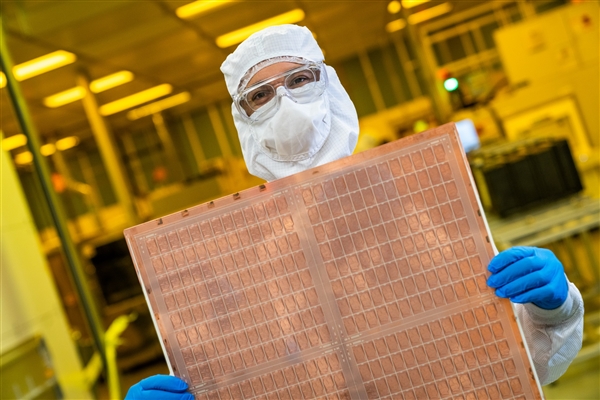




登录可免费下载软件
VIP可高速下载,支持百度、123网盘、蓝奏网盘等全站资源。
永久VIP可加入专属群,享受群内福利,享受1对1服务。
非VIP会员类型
分普通会员、黄金会员、钻石会员,不同会员的下载次数各不相同。
可通过积分兑换及签到获取积分。
联系客服
如链接失效或有其他问题,请联系客服微信:
diannaodiyquan 或 diannao10zv或者diy10zv
(备注:“电脑DIY圈”以防封号)
免责声明
1. 软件全部来源于网络,如有侵权请联系客服。
2. 本站一切资源不代表本站立场,并不代表本站赞同其观点和对其真实性负责。
3. 本站一律禁止以任何方式发布或转载任何违法的相关信息,访客发现请向站长举报。
4. 本站资源大多存储在云盘,如发现链接失效,直接跟帖催更我们会第一时间回复。
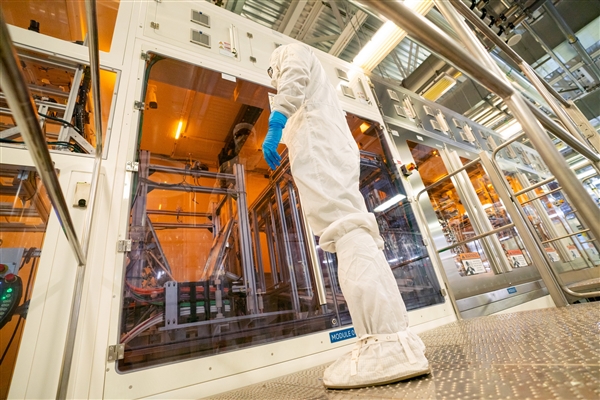














暂无评论内容